蔚山科学技术大学(UNIST)半导体材料与器件工程研究生院金正焕教授与郑昌旭教授团队研究发现,半导体研发中广泛应用的场效应迁移率(FEM)指标存在关键缺陷:受器件结构影响,其测量值可能被放大多达30倍,导致对器件性能的高估。该团队在ACS Nano期刊上提出标准化设计指南,旨在通过优化薄膜晶体管(TFT)结构消除测量误差,为半导体行业提供更可靠的评估方法。
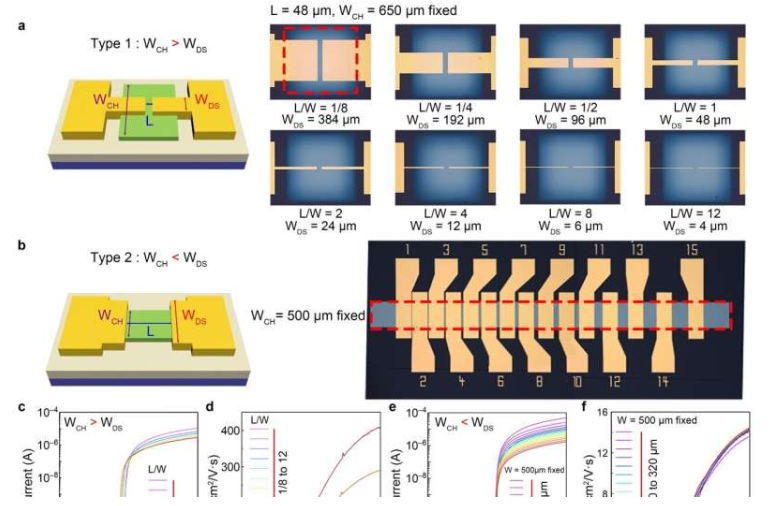
FEM作为衡量半导体载流子移动效率的核心参数,直接影响芯片运行速度与功耗。然而,研究指出,氧化物TFT的几何结构会引发边缘电流——当沟道宽度超过电极宽度时,电流会通过主沟道外的边缘区域流动,而传统测量设备会将这部分电流纳入统计,导致FEM值被人为夸大。团队通过实验与仿真验证,提出将沟道宽度设计窄于电极宽度,或确保电极宽度与器件长度比值(L/W)≤1/12的标准化准则,可最大限度减少边缘电流干扰,实现FEM的精确测量。
为进一步验证结果,团队建议结合霍尔迁移率测量——该指标直接反映半导体材料的固有电学特性,与器件结构无关,可提供不受几何误差影响的补充数据。金正焕教授强调:“测量误差会误导材料筛选与器件比较,阻碍行业技术迭代。制定全球统一的FEM评估标准,是推动半导体研究可靠性的关键一步。”
更多信息: Soohyun Kim 等人,《薄膜晶体管中的迁移率高估:器件几何形状和边缘电流的影响》,ACS Nano (2025)。期刊信息: ACS Nano
