近日,一个由斯坦福大学、卡内基梅隆大学、宾夕法尼亚大学及麻省理工学院研究人员组成的团队,与晶圆代工厂SkyWater Technology合作,成功制造出一种新型单片三维集成芯片。该成果展示了超越传统二维芯片的显著性能提升。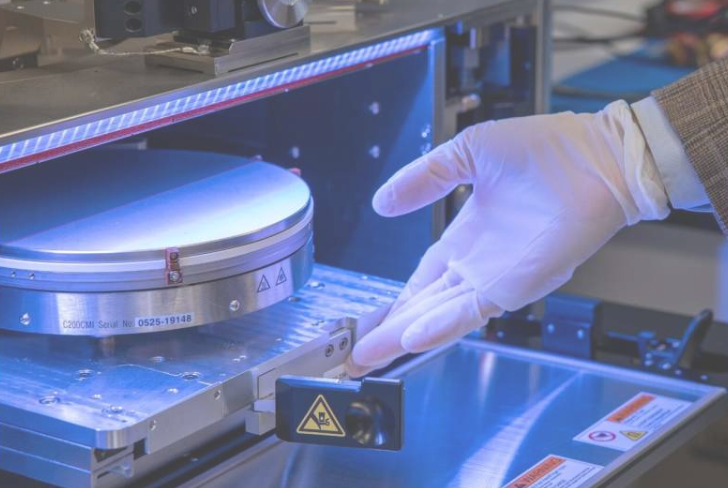
与当前主流的扁平化设计不同,这款原型芯片的关键组件像高层建筑的楼层一样垂直堆叠,通过高密度的垂直连接进行数据高速传输。该单片三维集成芯片在硬件测试中表现出的性能,约为同类二维芯片的四倍。相关研究在近期于旧金山举行的第71届IEEE国际电子器件年会(IEDM 2025)上发布。
传统芯片架构面临“内存墙”和“小型化瓶颈”等挑战。论文资深作者、卡内基梅隆大学助理教授塔塔加塔·斯里马尼解释道:“通过垂直整合内存和计算,我们可以更快地传输更多信息,就像高层建筑中的电梯可以让许多居民同时在楼层之间穿梭一样。”
此次突破的关键在于单片制造工艺,即在商业代工厂内将多层电路直接连续叠加在单一晶圆上,而非事后粘合多个独立芯片。论文主要研究者、斯坦福大学教授苏巴希什·米特拉表示:“这开启了芯片生产和创新的新时代。正是像这样的突破,才能让我们实现未来人工智能系统所需的1000倍硬件性能提升。”SkyWater公司技术开发运营副总裁马克·尼尔森认为,这表明先进的三维集成架构已具备在国内大规模生产的可行性。
研究人员对更高层数的设计进行了模拟,结果显示在处理源自大型语言模型的实际任务时,其性能提升可达12倍。该单片三维集成芯片架构为实现计算速度与能效的综合指标(能量延迟积)的百倍乃至千倍提升开辟了可行路径。
