最近,美国存储器巨头 Micron Technology 宣布在新加坡破土动工建造一座新的 HBM(高带宽存储器)先进封装工厂。

该设施将是新加坡首个此类设施,计划于 2026 年开始运营。从 2027 年开始,美光的先进封装产能将大幅扩大,以满足人工智能 (AI) 推动的不断增长的需求。该设施的推出将进一步增强新加坡的本地半导体生态系统并推动创新。
美光透露,它将在 HBM 先进封装领域投资约 70 亿美元(相当于约 513.2 亿人民币),初步创造约 1,400 个工作岗位。随着未来的扩建计划,该工厂预计将创造大约 3,000 个工作岗位,包括包装开发、组装和测试方面的职位。
除了美光之外,HBM 市场的另外两家主要参与者 SK 海力士和三星电子近年来也增加了对先进封装的投资。
对于 SK 海力士来说,其最受关注的项目是在美国建设一座先进封装工厂。2024 年 4 月,SK 海力士宣布计划在美国印第安纳州西拉斐特建立 AI 优化内存先进封装生产设施。
该公司还计划与当地研究机构合作进行半导体研发,预计投资额为38.7亿美元。
SK 海力士预计印第安纳州工厂将于 2028 年下半年开始量产面向 AI 的下一代 HBM 存储器产品。该项目已获得美国商务部 (U.S. Department of Commerce) 的 4.58 亿美元资金,以及美国芯片计划办公室 (U.S. CHIPS PROGRAM OFFICE) 提供的高达 5 亿美元的贷款。
与此同时,三星电子也在扩大其在国内和国际上对先进半导体封装的投资,重点是中国、日本和韩国。
中国:三星已经在苏州建立了一个测试和封装工厂,这是其最重要的海外生产基地之一。
日本:三星正在横滨设立先进封装实验室,致力于为 HBM、AI 和 5G 技术等高价值应用开发下一代封装技术。
韩国:三星正在扩建其位于忠清南道的半导体封装工厂,以提高 HBM 的产量。扩建工程预计将于 2027 年 12 月完成,将包括 HBM 芯片的先进封装生产线。
HBM5 20-Hi 堆栈和混合键合技术的兴起
目前的先进封装技术主要包括 Micro Bump Stacking 和 Hybrid Bonding。虽然 Micro Bump 堆叠被广泛采用,但 Hybrid Bonding 消除了对凸块的需求,从而允许更高的堆叠数量、更厚的芯片层和改进的翘曲控制。
尽管 Hybrid Bonding 尚未表现出与 Micro Bump 相比的显着优势,但它提供了更快的数据传输和更好的散热,使其在业内越来越受欢迎。
根据 TrendForce 集邦咨询的研究报告,考虑到堆叠高度限制、IO 密度和散热要求,三大 HBM 制造商有望在 HBM5 20-Hi 一代中采用 Hybrid Bonding。
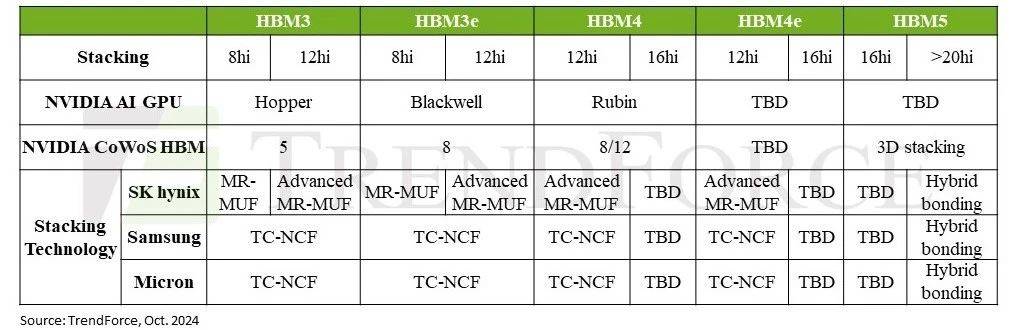
TrendForce 集邦咨询相信采用 Hybrid Bonding 可以改变 HBM 生产的商业模式。晶圆到晶圆堆叠工艺需要 HBM 基础芯片和内存芯片之间的芯片尺寸精确对齐。
由于 GPU/ASIC 公司经常设计基础晶片,因此提供基础晶片设计和晶圆代工服务的台积电可以在将基础晶片与内存晶片堆叠方面发挥关键作用。这可能会影响 HBM 制造商在基模设计、堆叠和订单履行等领域的行业地位。
然而,混合键合也带来了挑战,例如颗粒控制问题、更高的单位投资成本以及由于晶圆到晶圆堆叠工艺而导致的效率问题。如果前端生产良率太低,则整个过程在经济上可能不可行。
行业专家建议,当制造商进入 HBM 市场时,选择先进的封装技术必须平衡实际考虑,例如资金、技术能力和更广泛的战略因素。










