半导体材料在存储芯片和太阳能电池等器件中扮演核心角色,但其内部可能存在的微观缺陷会阻碍电流传输,影响性能。一个由韩国科学技术院与IBM研究中心组成的联合团队,近日开发出一种新型分析方法,能够以比现有技术高出约1000倍的灵敏度,检测出这些关键的“电子陷阱”。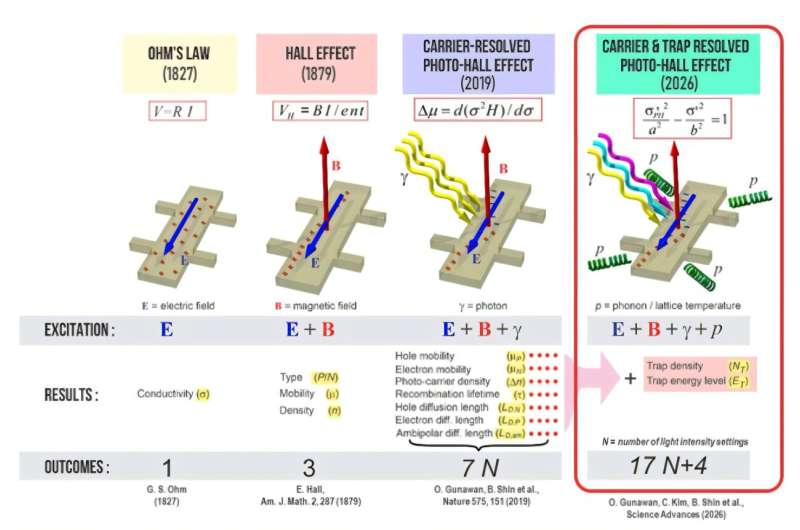
这项成果已发表于《科学进展》杂志,由韩国科学技术院材料科学与工程系的申炳河教授与IBM的冈万大树博士共同领导,博士生金彩妍为第一作者。该半导体缺陷检测技术旨在同步分析阻碍电子传输的陷阱特性与材料内部的电荷载流子传输行为,为优化材料性能提供关键数据。
半导体中的电子陷阱会俘获自由电子,导致漏电流增加与器件效能下降。传统评估方法在精确量化陷阱密度及其捕获能力方面面临挑战。研究团队对经典的霍尔测量法进行了创新改进,通过引入可控的光照与温度变化条件,成功提取了此前难以获得的信息。在弱光条件下,新产生的电子优先被陷阱捕获;随着光照增强,陷阱被填满后,电子方能自由移动。分析这一动态过程,使得精确计算电子陷阱的密度与特性成为可能。
该方法的显著优势在于单次测量即可获取多维信息,不仅能评估电子的迁移率、寿命和扩散距离,还能直接分析干扰传输的陷阱属性。团队首先在硅半导体上验证了此新型测量技术的准确性,随后将其应用于具有潜力的下一代太阳能电池材料——钙钛矿,成功检测到了传统手段难以发现的极微量缺陷。
申炳河教授指出:“这项研究提出了一种新方法,可以通过一次测量同时分析半导体中的电传输及其阻碍因素。” 他表示,这将成为提升包括存储半导体和太阳能电池在内的多种器件性能与可靠性的重要工具。这项高灵敏度分析技术有望缩短半导体材料的研发周期,降低开发成本,并最终提升产品的使用寿命与能效。
更多信息: 作者:Oki Gunawan 等人,标题:《利用载流子分辨光霍尔效应检测电子陷阱》,发表于:《科学进展》 (2026)。期刊信息: 《科学进展》
